在BGA下采用底层填充技术加强焊点,增强产品的抗振动和热冲击性
在BGA下采用底层填充技术加强焊点,增强产品的抗振动和热冲击性。当受到更大的温度变化时,硅芯片和PCB基板之间的热膨胀系数的差异通常会导致热冲击试验期的相对偏移,导致焊点脱落或断裂。底部填充技术有效地加强了焊球和电路板之间的焊点,增加了产品的抗振动性,降低了热应力损坏,提高了产品的可靠性,从而提高了产品的使用寿命。
|
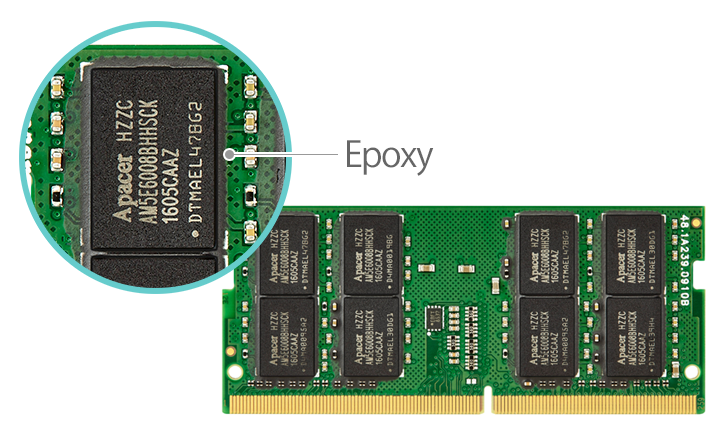 |
|
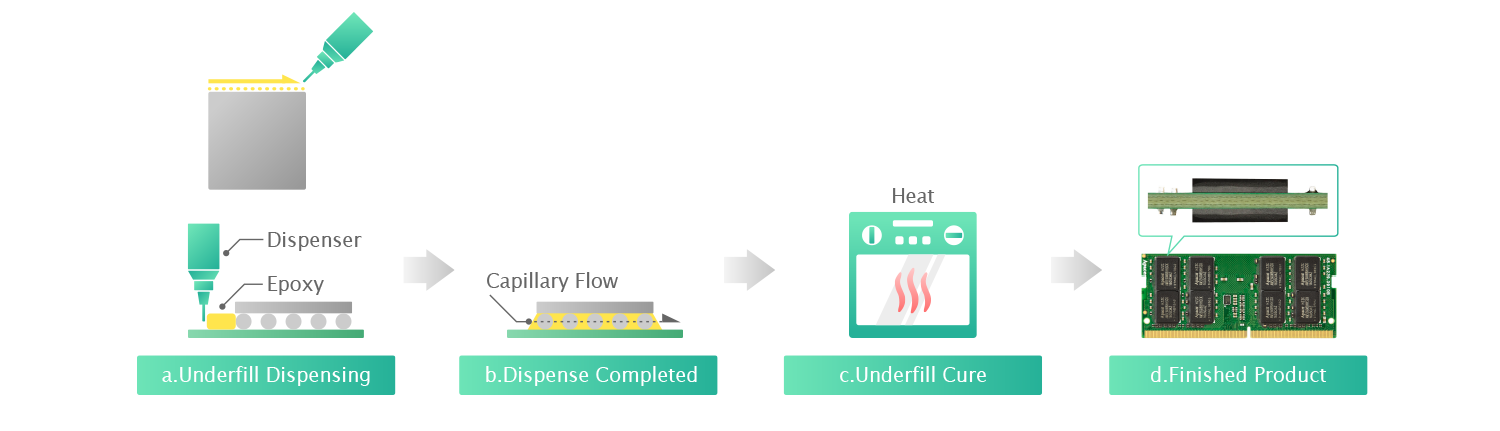
环氧树脂通常用作底层填料。沿着芯片的边缘注入,并通过毛细作用使其沉淀在BGA芯片的底部。然后将基板加热以增加焊点的机械强度并增强产品的抗冲击性。 |
|
 |
宇瞻提供底部填充技术,以提高产品的可靠性和抵抗各种热和机械冲击,确保产品在高振动和环境温度变化极大的情况下继续正常运行。适用于军事,车载,户外和强固电脑等工业设备的理想解决方案。 |
|





